直接影響B(tài)GA返修良率的三大重要因素
眾所周知在BGA芯片返修環(huán)節(jié)中,直接影響B(tài)GA返修成功率的重要原因有三種即:貼裝的精度、精準(zhǔn)的溫度控制、是否有足夠的預(yù)熱,除此之外還有別的因素,只不過這幾個(gè)因素比較難把握因此整理出來一同處理,接下來詳細(xì)介紹一下吧。
一、BGA返修時(shí)確保貼裝精度
焊接bga元器件必須確保一定的貼裝精度,不然就會引起空焊。錫球在焊接加熱時(shí),有一定的自對中效應(yīng),容許有輕微誤差,在貼裝時(shí),將期間的殼體中心與絲印外框中心相似重疊,就可以視為貼裝位置正確。在未使用光學(xué)級bga返修臺的情況之下,也可以根據(jù)移動bga時(shí)的手感判斷是否存在接觸(這點(diǎn)的話較為主觀性,每一個(gè)人感覺不一定相同)。光學(xué)級BGA返修臺能看清bga元器件與焊盤是否對齊,并自動焊接。目前我國的bga返修臺基本使用的是上下部熱風(fēng),底部紅外提前預(yù)熱的方式,此外還要采用科學(xué)合理設(shè)計(jì)的風(fēng)嘴,避免加熱時(shí)熱風(fēng)將bga移動。
二、控制所需BGA返修溫度與時(shí)長
科學(xué)合理、高質(zhì)量返修必須與其相適應(yīng)的返修溫度曲線,掌握好溫度與時(shí)長,要在bga所能承受的范圍內(nèi),標(biāo)準(zhǔn)條件下,有鉛小于260℃,無鉛小于280℃。如果溫度控制不是很精準(zhǔn),溫度波動范圍大,那就非常容易損壞bga元器件。同時(shí)加熱時(shí)長過久的話,返修次數(shù)不要太多,在高溫下情況下會造成bga的氧化,時(shí)間久了會縮短bga的壽命。
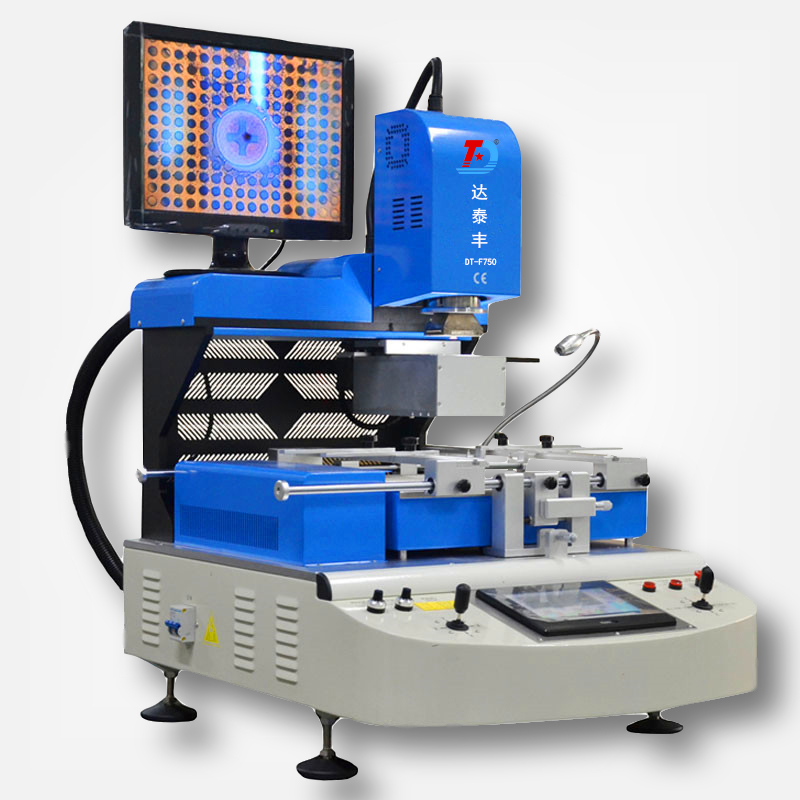
三、足夠的提前預(yù)熱,預(yù)防板出現(xiàn)變形
在焊接或者拆卸bga元器件時(shí),由于只單獨(dú)加熱相應(yīng)的BGA元器件,很容易會導(dǎo)致bga與周圍的溫差過大,板子就很容易出現(xiàn)變形、損壞,因此返修bga時(shí),不僅需要固定住板子和bga所在部位,一般bga返修臺返修時(shí)會采用下部風(fēng)嘴頂住PCB板,且下部有風(fēng)能夠起到很好的支撐作用,如果采用風(fēng)槍拆焊的話,那就更需要固定住板子,避免加熱時(shí)發(fā)生出現(xiàn)變形直接導(dǎo)致PCB損壞,另外還必須對PCB板整體進(jìn)行一個(gè)提前預(yù)熱,從而降低溫差,能有效防止出現(xiàn)變形。
相信在BGA返修環(huán)節(jié)中,把上述幾點(diǎn)關(guān)鍵的因素掌握后,BGA返修良率不會太低。當(dāng)然了,我們也應(yīng)該確保使用的BGA返修臺是符合返修的要求,這里推薦達(dá)泰豐科技全自動BGA返修臺DT-F750,想了解可以去看看。
